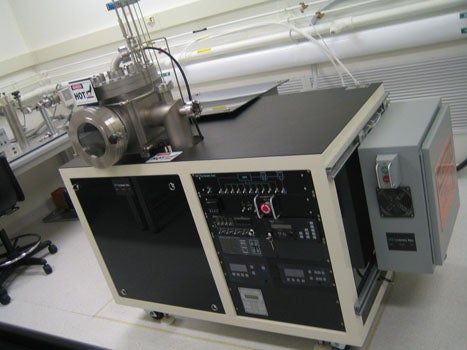
It is rated to operate at temperatures up to 1000°C at the substrate. The system consists of one water cooled RF PECVD chamber.
The process gases are SiH4, PH3/H2, CF4, NH3, He, and N2. The system is suitable for poly-Si and nanostructured Si (e.g., Si nanowires, etc.) deposition.